
新聞動態
NWES
04
2024
-
06
科普分享|半導體設備縱覽
作者:
來源:公眾號:光學與半導體綜研
半導體產業鏈
半導體產業鏈的上游是軟硬件材料及設備,中游是集成電路的設計、生產,下游是終端 產品應用。半導體產業鏈中游包括設計、制造和封測三大環節。封測是產業鏈中游的最后一個環節,芯片經過封測之后交付給芯片設計廠,再銷售給下游終端產品應用企業。

從半導體設備產業鏈來看,半導體設備產業鏈上游主要為零部件及系統,零部件主要包括軸承、傳感器、反應腔噴淋頭、射頻發生器、石英、機械臂、泵等;核心子系統主要包括氣液流量控制系統、真空系統、制程診斷系統、光學系統、熱管理系統、集成系統等。產業鏈中游主要為半導體設備,主要包括光刻機、刻蝕機、清洗設備、量測設備、分選機等。產業鏈下游主要為半導體制造,企業主要包括華潤微電子、士蘭微、通富微電、水晶光電等。

半導體設備
根據用于工藝流程的不同,半導體設備通常分為制造設備(前道設備)和封測設備(后道設備)。前道設備主要包括光刻機、刻蝕機、薄膜沉積設備、CMP設備、清洗設備、離子注入機設備、熱處理設備等。后道設備主要分為封裝設備和測試設備,封裝設備主要包括劃片機、貼片機、裂片機、引線鍵合機、切筋成型機等,測試設備主要包括分選機、測試機、探針臺等。


前道晶圓制程工序:
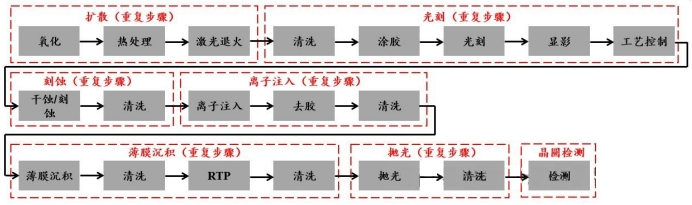
半導體設備價值占比:


半導體封測
封測是封裝測試的簡稱,包括封裝和測試兩個環節。其中,封裝是指將生產加工后的晶圓進行切割、焊線塑封,并加工為成品芯片的過程,測試則是指利用專業設備對產品進行功能和性能測試。
封裝:指用特定材料、工藝技術對芯片進行安放、固定、密封,并將芯片上的接點連接到封裝外殼上的工藝流程,其可保護芯片性能并實現芯片內部功能的外部延伸。基本的封裝工藝流程包括:晶圓減薄(wafer grinding)、晶圓切割(wafer Saw)、芯片貼裝(Die Attach)、焊接鍵合、塑封工藝、后固化工藝、測試、打標工藝(電鍍、打彎、激光打印)、包裝、倉檢、出貨等工序。
半導體封裝工藝流程圖:

測試:指對芯片產品的性能和功能進行測試,并挑選出功能、性能不符合要求的產品。測試主要分為封裝之前的晶圓測試(Chip Probing)和封裝之后的芯片成品測試(Final Test)。測試在確保芯片良率、控制成本、指導芯片設計和工藝改進等方面起著至關重要的作用。




廠家布局







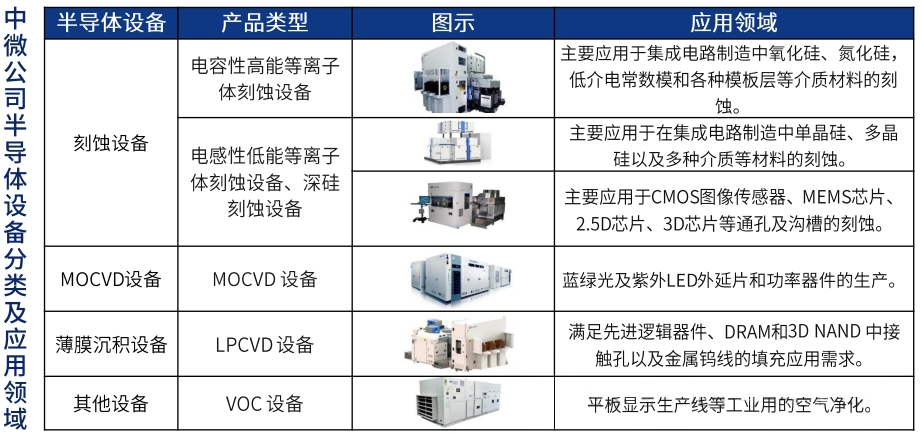

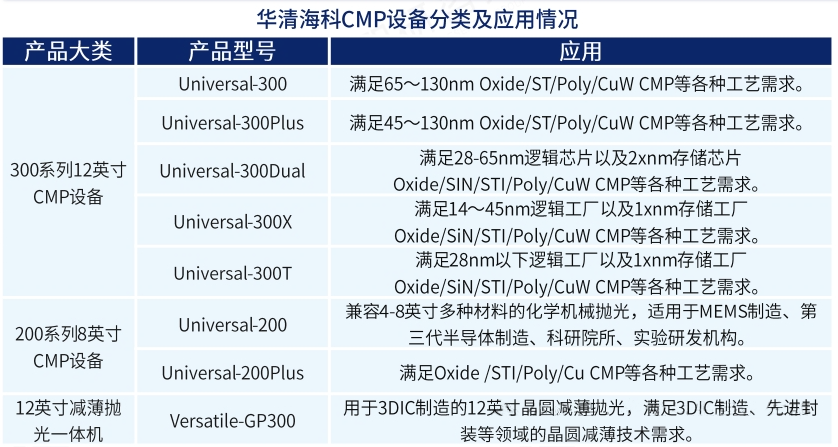
免責聲明:本文系網絡轉載或改編,版權歸原作者所有。文章內容系作者個人觀點,轉載僅為了傳達一種不同的觀點,不代表公司對該觀點贊同或支持,如果有任何異議,歡迎聯系我們。
推薦新聞




