11
2024
-
06
科普分享|極紫外(EUV)光刻
作者:
來源:公眾號:光學與半導體綜研
極紫外光譜/軟X射線電磁輻射譜是指波長為5~30nm的波譜。與曝光波長為248nm和193nm的深紫外(DUV)光刻類似,EUV光刻也使用投影物鏡對掩模進行縮小成像。由于EUV光刻的曝光波長短,其分辨率明顯高于DUV光刻。從DUV波段光學光刻到EUV光刻有幾個重要變化:1、需要輸出功率高、壽命長且穩(wěn)定的光源。業(yè)內已開發(fā)了多種激光等離子體或放電等離子體光源。2、由于缺乏在EUV波段透過率足夠高的光學材料,照明/投影光學系統(tǒng)不能采用傳統(tǒng)的透射式透鏡,必須替換為反射式光學元件,對掩模和EUV光刻系統(tǒng)的成像特性產生了重要影響。3、需要高靈敏度、高分辨率的光刻膠材料。高能EUV光子改變了入射光與光刻膠相互作用的方式。光子噪聲、二次電子散射效應和其他現(xiàn)象都會影響光刻膠的靈敏度,分辨率和線邊粗糙度。
EUV光刻系統(tǒng)的曝光波長取決于光源與材料,目前使用的波長為13.5nm。下圖為極紫外投影光刻系統(tǒng)的原理圖。收集鏡將激光等離子體輻射出的EUV光聚焦到中繼焦點上。照明系統(tǒng)采用四面反射鏡對EUV光進行整形,并照明掩模臺上的反射式掩模。投影物鏡系統(tǒng)由6面反射鏡組成,將掩模4X縮小成像至硅片上的光刻膠內。因為所有材料對13.5nm光的透射率都不足,所以系統(tǒng)需要運行在真空環(huán)境中。

本文重點介紹EUV光源、多層膜反射鏡以及高數(shù)值孔徑光刻。多層膜反射鏡是極紫外光刻掩模和成像系統(tǒng)的重要組成部分,以反射式掩模和反射鏡取代透射式掩模和透鏡,對掩模和成像產生了重要影響。
光源
首次EUV光刻實驗使用了同步加速器自由電子激光。由于功率低且成本高,這種同步加速器光源不適用于大規(guī)模量產。等離子體中的高能電子態(tài)也可以產生EUV輻射。可利用氙、錫、鋰等靶材形成等離子體。放電等離子體光源和激光等離子體光源都曾被用于EUV光刻。轉換效率(在窄波長范圍內EUV光的功率與輸入的電或光功率的比值)取決于靶材、靶的形狀以及等離子密度等參數(shù),為達到2%~5%的轉換效率,較新的一些光源系統(tǒng)普遍使用錫作為靶材。下圖為放電等離子體(DPP)光源和激光等離子體(LPP)光源示意圖。通過進料口或激光燒蝕技術,將靶材從錫陰極輸送到DPP的陰極和陽極之間。通過放電(DPP)或高功率CO2激光器(LPP)產生等離子體。出射的EUV光的峰值波長為13.5nm。等離子體也會產生帶外(OOB)EUV輻射,以及紫外光和可見光。采用薄膜、多層膜反射鏡或特殊光柵等光譜純化濾波器可減少進入照明系統(tǒng)的帶外輻射。DPP和LPP光源都會產生顆粒/微液滴、離子以及電子等高速運動的碎屑。這些碎屑可能會損壞照明和投影系統(tǒng)的光學元件。箔片陷阱可消除或者減少光路中的碎屑。多層膜或掠入射收集鏡將除污之后的EUV光反射到光源與照明系統(tǒng)之間的中繼焦點。DPP和 LPP光源的轉換效率低,說明大部分輸入功率轉換為了帶外輻射、碎屑和熱損耗,所以會產生高熱負載。如何有效處理熱負載成為這兩種EUV光源共同面臨的挑戰(zhàn)。碎屑會對反射鏡以及等離子體周圍的其他光源模塊造成損傷,嚴重影響極紫外光源的壽命與穩(wěn)定性。轉換效率、光譜濾波器、碎屑緩減系統(tǒng)以及高熱負載處理方法制約了EUV光源的輸出功率。另一方面,產率指標要求中繼焦點的輸出功率最低要達到200W。輸出功率的穩(wěn)定性與光源的壽命也是EUV光源研發(fā)面臨的挑戰(zhàn)。上述問題以及光源性能的不足,使得 EUV 光刻技術應用于半導體制造的時間推遲了很多年。
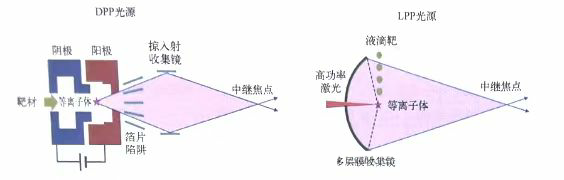
極紫外光刻機采用了LPP光源和預脈沖技術,如圖所示。預脈沖(PP)的作用是增大錫液滴的體積,改善錫液滴與主脈沖(MP)的相互作用效果。完美的時空同步以及預脈沖技術顯著提高了轉換效率,使得EUV光源的輸出功率超過了 250W。預脈沖技術是將EUV光刻技術推向半導體制造過程中的重要一步。除了上述兩種光源之外,還存在自由電子激光和共振高次諧波激光等其他類型的EUV光源。自由電子激光未來有可能用作EUV光刻光源。高次諧波激光可用于EUV計量。

多層膜反射系統(tǒng)
所有EUV光譜范圍內的材料都具有相似的光學性質,都會吸收EUV光,限制了元件對EUV光的操控能力。在極紫外光譜范圍內無法使用類似透鏡的折射元件。透射光柵、波帶片或針孔等衍射元件的衍射效率低,雖然無法應用于高產率光刻成像系統(tǒng),但可用于計量和一些特殊的應用場合。為實現(xiàn)高反射率,需要采用大的入射角(掠入射反射鏡)或者能夠使來自反射元件不同界面(多層膜反射鏡)的反射光發(fā)生相長干涉。EUV成像光學系統(tǒng)和掩模采用多層膜結構。該多層膜由雙層膜周期性地堆疊而成,如下圖所示。
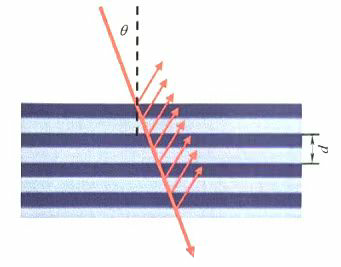
布拉格定理給出了不同界面的反射光發(fā)生相長干涉需要滿足的條件:

式中d為雙層膜的厚度,λ為波長,m為整數(shù)。所需雙層膜的數(shù)量與可實現(xiàn)的反射率值取決于雙層膜兩種材料折射率實部之間的差異。為了使兩種材料的光學性質差異足夠大,雙層膜常采用具有高低兩種原子序數(shù)的材料。選擇材料時還需要考慮含突變界面連續(xù)薄膜的制造能力等其他方面的技術要求。目前的掩模中使用了40對鉬(Mo)和硅(Si)組成的雙層膜。這些材料之間的折射率對比度很高,而且它們對EUV光的吸收相對較小。可以用傳遞矩陣法計算Mo/Si多層膜的反射率,下圖顯示了典型Mo/Si多層膜的反射率值隨波長和入射角的變化曲線。在工作波長13.5nm處、0°~12°入射角范圍內,理論反射率可達70%左右。圖中,虛線和右圖無陰影區(qū)域表示標稱波長、入射角,以及與數(shù)值孔徑0.33相對應的人射角范圍。

吸收層位于Mo/Si多層膜上面,主要作用是產生EUV光刻掩模圖形。入射角為6°的傾斜照明將反射光與入射光分開。多層膜反射率隨入射角和斜射照明的變化而變化,導致了幾種EUV光刻特有的成像現(xiàn)象。下圖是典型EUV光刻掩模的橫截面圖。在熱膨脹性超低的基底上沉積了40對 Mo/Si 雙層膜。為了在一定入射角范圍內獲得高反射率,需要對Mo和Si層的厚度進行優(yōu)化。釕頂蓋層的厚度為幾納米,可使多層膜免受氧化以及其他物理和化學作用的影響。吸收層的作用是產生不透光的圖形,通常由一種或多種材料組成。頂部吸收層的化學成分取決于吸收層沉積工藝,以及吸收層與局部環(huán)境的相互作用。吸收層膜層需要能夠抑制極紫外光的反射,并便于利用深紫外光對掩模進行計量和檢測。
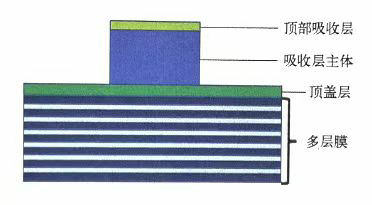
下圖展示了光經過EUV掩模的衍射過程。圖中給出了各個衍射級穿過掩模傳播的光路。吸收層和多層膜反射鏡都被簡化為無限薄的光學元件。通過設定吸收層和多層膜之間的距離,將多層膜簡化為位于真實多層膜內的一個反射面。光源發(fā)出的光向下傳播,照射到吸收層后發(fā)生衍射,形成離散的衍射級次。衍射光照射到多層膜上,所有級次都被反射回吸收層。向上傳播的級次再一次照射到吸收層發(fā)生衍射。吸收層頂部向上傳播的光包含兩套衍射級,代表光的兩次衍射。-3/+3、-2/+2、-1/+1、0/0、+1/-1…級衍射光相干疊加產生了光瞳內的0級衍射級。這些衍射級的強度不同,在吸收層和(多層)反射鏡之間傳播時產生的相位延遲也不同。投影物鏡光瞳內的其他衍射級次也類似。二次衍射以及吸收層和多層膜有效反射面之間傳播距離和相位延遲的不同導致EUV光刻具有一些DUV光刻所沒有的特殊成像效應。

EUV高數(shù)值孔徑光刻工藝
EUV光刻采用了反射式投影系統(tǒng)設計,需要平衡成像質量和光強傳輸效率。每個多層膜反射鏡只能反射約65%的入射光。增加反射鏡數(shù)量會引入更多的優(yōu)化自由度,有利于提高成像質量,但會降低系統(tǒng)的光強傳輸效率。當前,NA為0.33的系統(tǒng)使用了六面反射鏡。下圖為EUV 投影系統(tǒng)的設計示例。可以看到增大NA對硅片面的影響。NA增加后需要一面更大的(最后一面)反射鏡。左側和中間所示的小NA系統(tǒng)中,倒數(shù)第二面反射鏡向外向右傾斜,最后一面反射鏡被倒數(shù)第二面反射鏡照明。進一步增加傾斜度將導致光在最后一面反射鏡上的人射角范圍過大,反射率損失嚴重。
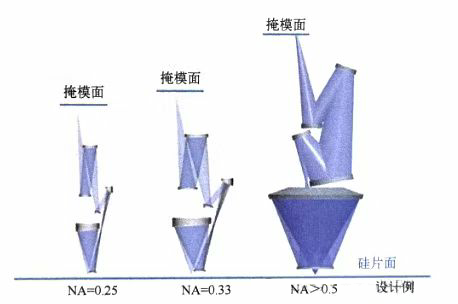
因此,高NA系統(tǒng)的倒數(shù)第二面反射鏡沒有傾斜,而是采取了在最后兩面反射鏡上鉆孔的方案。這些孔在投影光瞳的中心產生一個暗區(qū)或遮攔。中心遮攔僅占光瞳面積的4%~6%,實際應用時不會對成像性能造成明顯影響。下圖顯示了增大4x縮小成像系統(tǒng)的N給掩模面帶來的影響。掩模/照明面的數(shù)值孔徑定義為NA(illu)=NA/M,其中M是投影系統(tǒng)的放大(縮小)倍數(shù),通常為4。如左圖所示,NA=0.33的系統(tǒng)中,在物方入射角為主光線角(CRAO=6°)的傾斜照明條件下,入射光與掩模反射光可以分開。對于給定系統(tǒng),增加NA將導致入射光錐和反射光錐發(fā)生明顯重疊。采用這種結構無法將入射光和反射光分開。
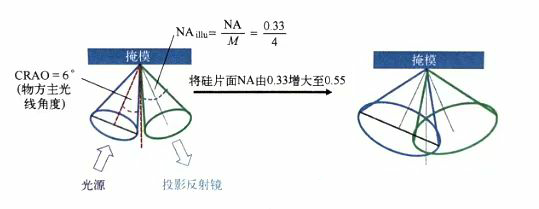
解決該問題的第一個方法是將CRAO增加到9°左右。較大的CRAO和反射式掩模增大了高NA EUV投影系統(tǒng)的復雜度。如下圖所示,當入射角在投影物鏡光瞳面上接近右邊緣時,多層膜反射率明顯下降。在這樣的入射角下,多層膜反射率的降低導致的對比度損失過大,特別是對于水平方向密集圖形。改變縮小倍率是避免高數(shù)值孔徑EUV系統(tǒng)中入射光和反射光發(fā)生重疊的方案。下圖的中圖和右圖為改變縮小倍率之后的系統(tǒng)。中圖為x和y方向縮小倍率都為8(8x/8x)的系統(tǒng)及其相應反射率圖。右圖為非掃描方向和掃描方向縮小倍率分別為4和8(4x/8x)的組合倍率系統(tǒng)及其相應反射率圖。兩種系統(tǒng)在主光線傾斜方向上的縮小倍率都更大。在有效入射角范圍內,掩模多層膜的反射率幾乎相同。沿x軸(垂直于主光線的傾斜方向)的縮小倍率變化對光瞳內的多層膜反射率幾乎沒有影響。

組合倍率投影物鏡的應用對照明系統(tǒng)和掩模都產生了重要影響。在x和y方向上,照明系統(tǒng)和掩模的形狀都必須按給定的比例進行縮放。如下圖所示,物方橢圓形照明光瞳在像方轉換為圓形光瞳。組合倍率照明可以由非對稱場鏡和相應的非對稱瞳鏡產生。

下圖為掩模圖形從物方到像方的變化示意圖。實際中需要根據物方拉伸后的圖形制作掩模。由于線寬較小,垂直圖形(沿y方向)對掩模形貌效應更敏感。
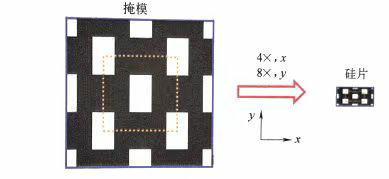
高NA系統(tǒng)出射光線的角度更大(像面),對偏振效應更敏感。EUV光刻等離子體光源的出射光是非偏振光。非偏振光照明條件下的成像對比度比優(yōu)化后偏振光照明條件下的成像對比度低。DUV光刻中光在空氣/水/光刻膠界面處的折射降低了偏振對成像的影響。不同于DUV光刻,EUV光在真空和光刻膠(折射率非常接近1)內的偏振效應幾乎相同。EUV光與多層膜光學元件、掩模之間的相互作用會產生額外的偏振效應。理解與處理相關效應對推動高NA EUV光刻技術向其極限發(fā)展非常重要。
免責聲明:本文系網絡轉載或改編,版權歸原作者所有。文章內容系作者個人觀點,轉載僅為了傳達一種不同的觀點,不代表公司對該觀點贊同或支持,如果有任何異議,歡迎聯(lián)系我們。
推薦新聞





